Soft Solder Die BonderBESTEM-D03Hp
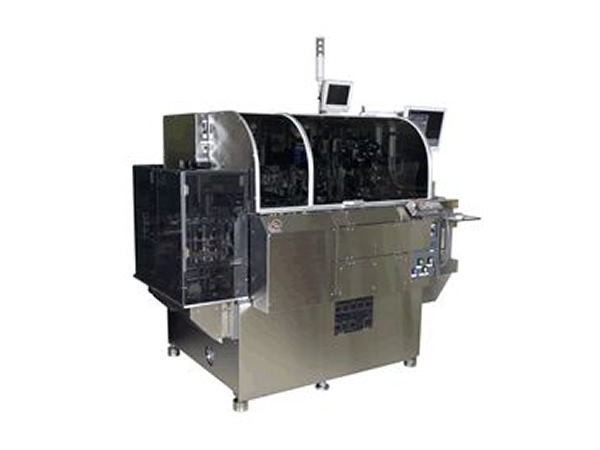
- Overview
- Specifications
Basic Information
Model name : BESTEM-D03Hp
A solder die bonder compatible with high-quality, high-power devices, such as Dpak, To220, To3p and IGBT.
Features
1.Compatible with high-quality high-power devices from Dpak, To220 to To3p.
2.Bonding accuracy: XY: ± 40 μm‚ θ: ± 3° 3 σ
3.Solder bonding quality inspection / detection with DBI.
4.The exchange of heater rail unit or adapter rail can be selected.
Main Specs
- Bonding Method
- Solder bonding
- Bonding Speed
-
0.6 sec/cycle (Dpak: Die size □3 mm)
1.5 sec/cycle (To3p frame Die size □5 mm)
- Bonding Accuracy
-
Single row frame : XY:± 40 µm θ: ± 3゜
(□5 mm, Pyramid collet)
- Die Size
-
□3-□8 mm
t=0.08-0.5 mm
- Lead frame Size
- Length : 150–260 mm, Width : 30–80 mm, Thickness : 0.5–2.0 mm
- Magazine Size
- Length : 120–260 mm, Width : 30–90 mm, Height : 50–200 mm, Pitch : 3 mm–
- Wafer Size
- Max φ8 inch
- Dimensions
- (W) 1,870 × (D) 1,200 × (H) 1,650mm
- Weight
- Approximately 1,700 kg
Options
- Loader
- Double loader (magazine loader addition) / in-line compatibility
- Bonding Head
- Collet rotator
- DBI Function
- Bonding accuracy inspection
- Wafer Mapping Compatibility
- Wafer mapping system



 简体中文
简体中文 日本語
日本語 English
English